臺積電美國先進封裝廠計劃曝光:聚焦SoIC與CoW技術
據(jù)供應鏈透露,臺積電在美國的首座先進封裝廠計劃浮出水面,預計將于明年下半年動工。這座工廠將專注于SoIC(系統(tǒng)整合單芯片)和CoW(芯片堆疊于晶圓上)技術,而后段oS(基板上封裝)部分則可能委托Amkor完成。臺積電的美國先進封裝廠選址在亞利桑那州,與正在建設中的P3晶圓廠相連,未來將率先導入SoIC技術。
在AI需求的強勁推動下,臺積電正加大對美國的投資力度,總投資額高達1650億美元,涵蓋6座先進制程廠、2座先進封裝廠和1座研發(fā)中心。目前,首座晶圓代工廠已正式量產,良率與臺積電在中國臺灣的工廠相當。AMD執(zhí)行長蘇姿豐透露,今年底將收到首批由臺積電美國廠生產的芯片。
消息指出,承包商已開始招募CoWoS設備服務工程師,為未來機臺安裝與維護做準備。半導體業(yè)內人士表示,SoIC技術通過中介層整合芯片,已被應用于AMD的MI350產品,并可能用于蘋果M系列芯片。這一技術的引入旨在滿足日益多元的客戶需求。
IC設計業(yè)者分析稱,AMD下一代EPYC處理器“Venice”將采用臺積電2nm制程與SoIC封裝技術;英偉達(NVIDIA)預計明年推出的Rubin平臺也將采用SoIC設計,通過異質整合方式實現(xiàn)性能與成本的平衡。至于CoWoS封裝,將根據(jù)客戶需求分為S/L/R版本,后段oS制程將交由外部封測廠完成。
廠務業(yè)者表示,隨著P3廠建設加速,美國AP1封裝廠預計明年下半年啟動建設,相關機臺最快將在2029年完成移機與安裝。業(yè)界看好,濕制程設備供應商弘塑、辛耘、萬潤等企業(yè)將從中受益,搶占高階封裝市場新機遇。不過,臺積電的核心技術仍優(yōu)先在中國臺灣量產,待技術成熟后才會轉移至美國。








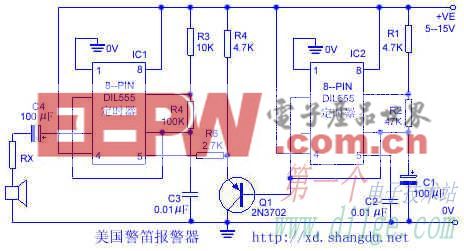

評論